Η Gigabyte γιορτάζει 40 χρόνια με τη σειρά AORUS INFINITY στο Computex 2026
X870E AORUS INFINITY NEXT: 3D μεταλλική εκτύπωση και 64 φάσεις τροφοδοσίας
Η κορυφαία X870E AORUS INFINITY NEXT ενσωματώνει ένα εξάρτημα ψύξης που η Gigabyte περιγράφει ως το πρώτο στον κλάδο με προηγμένη 3D μεταλλική εκτύπωση. Σύμφωνα με την εταιρεία, το νέο thermal module αυξάνει τη συνολική επιφάνεια ψύξης κατά 44% σε σύγκριση με συμβατικές σχεδιάσεις, ενώ η μητρική χρησιμοποιεί αρχιτεκτονική τροφοδοσίας 64 φάσεων με στόχο καλύτερη θερμική συμπεριφορά και σταθερότητα σε υψηλό φορτίο.
Η Gigabyte περιγράφει τη σχεδίαση της INFINITY NEXT ως συνδυασμό υλικών θερμικής διαχείρισης και προηγμένης μεταλλικής εκτύπωσης. Πίσω από τις πιο έντονες marketing διατυπώσεις της εταιρείας βρίσκονται τα VRM της μητρικής, τα οποία βασίζονται σε Infineon OptiMOS εξαρτήματα. Η X870E AORUS INFINITY NEXT τοποθετείται ως το νέο κορυφαίο μοντέλο της σειράς, με έμφαση στην τροφοδοσία και στη θερμική αρχιτεκτονική.
X870 AORUS INFINITY: περιστρεφόμενο socket και DDR5 έως 11.400 MT/s
Και οι δύο μητρικές είναι συμβατές με τους επεξεργαστές AMD Ryzen 9950X3D2, υποστηρίζουν ταχύτητες μνήμης έως 11.400 MT/s και ενσωματώνουν την τεχνολογία X3D Turbo Mode 2.0, την οποία η Gigabyte περιγράφει ως overclocking με υποβοήθηση AI.
Η X870 AORUS INFINITY στοχεύει στην επαναπροσδιορισμό της απόκρισης μνήμης στην πλατφόρμα AMD X870. Με timings CL24, δηλαδή δύο φορές πιο σφιχτά από τα τυπικά σύμφωνα με την εταιρεία, η Gigabyte ισχυρίζεται ότι επιτυγχάνει πλεονέκτημα ταχύτητας 20% και τη χαμηλότερη καθυστέρηση μνήμης που έχει καταγραφεί στην πλατφόρμα X870. Ασυνήθιστη είναι και η σχεδίαση του PCB, καθώς το socket AM5 και οι υποδοχές DIMM έχουν περιστραφεί σε σύγκριση με τη συμβατική διάταξη.
Στον πυρήνα της σειράς βρίσκεται το X3D Turbo Mode 2.0, η αποκλειστική τεχνολογία overclock της Gigabyte με υποβοήθηση τεχνητής νοημοσύνης. Οι μητρικές διαθέτουν ενσωματωμένο hardware chip που παρακολουθεί σε πραγματικό χρόνο τις συνθήκες λειτουργίας του συστήματος και τη συμπεριφορά του φορτίου εργασίας. Η X870 AORUS INFINITY βασίζεται στο chipset X870 και όχι στο X870E, κάτι που σημαίνει ότι χρησιμοποιεί μονό και όχι διπλό chipset όπως τα μοντέλα X870E.
AORUS GeForce RTX 50 INFINITY: από την RTX 5090 έως την RTX 5070 με STEALTH σχεδιασμό
Στον τομέα των καρτών γραφικών, η βραβευμένη με Red Dot Design Award AORUS GeForce RTX 5090 INFINITY παραμένει το κορυφαίο μοντέλο της σειράς. Ακολουθούν οι RTX 5080, RTX 5070 Ti και RTX 5070 INFINITY, όλες με την τεχνολογία ψύξης WINDFORCE Hyperburst και νέο STEALTH σχεδιασμό, ο οποίος μεταφέρει τον σύνδεσμο τροφοδοσίας στην πίσω πλευρά της κάρτας για καθαρότερη δρομολόγηση καλωδίων.
Τα νέα μοντέλα διαθέτουν επίσης RGB Halo δακτύλιο φωτισμού στο εξωτερικό μέρος της κάρτας, με σχεδίαση εμπνευσμένη από κινητήρες πυραύλων και δυνατότητα προσαρμογής των εφέ φωτισμού. Η ονομασία AORUS INFINITY εμφανίστηκε για πρώτη φορά στην GeForce RTX 5090 που παρουσιάστηκε στο CES 2026 ως η κάρτα για τα 40 χρόνια της Gigabyte. Παράλληλα, σύμφωνα με προηγούμενες αναφορές, η εταιρεία φαίνεται να ετοιμάζει και άλλες AORUS INFINITY παραλλαγές, χωρίς όμως να έχουν ανακοινωθεί επίσημα όλα τα μοντέλα.
Aero Wood Dark, MicroATX Stealth και υπόλοιπη σειρά
Στην ευρύτερη παρουσίαση του Computex, η Gigabyte ανακοίνωσε επίσης τη σειρά D5 DUO X, τη μητρική X870E AERO X3D DARK WOOD, σκοτεινή εκδοχή της γνωστής Aero Wood, και τη σειρά STEALTH σε MicroATX μορφή. Η online παρουσίαση της σειράς είχε προγραμματιστεί για τις 3 Ιουνίου 2026. Τιμές και ημερομηνίες γενικής διαθεσιμότητας για κανένα από τα προϊόντα δεν έχουν ανακοινωθεί ακόμη.
Πηγές
Tom's Hardware: Gigabyte showcases new Infinity products for its 40th anniversary Gigabyte: AORUS GeForce RTX 50 INFINITY Series, επίσημο press release VideoCardz: GIGABYTE unveils X870E AORUS INFINITY NEXT motherboard PC Gamer: Gigabyte borrows space industry tech for its 40th anniversary motherboards
230








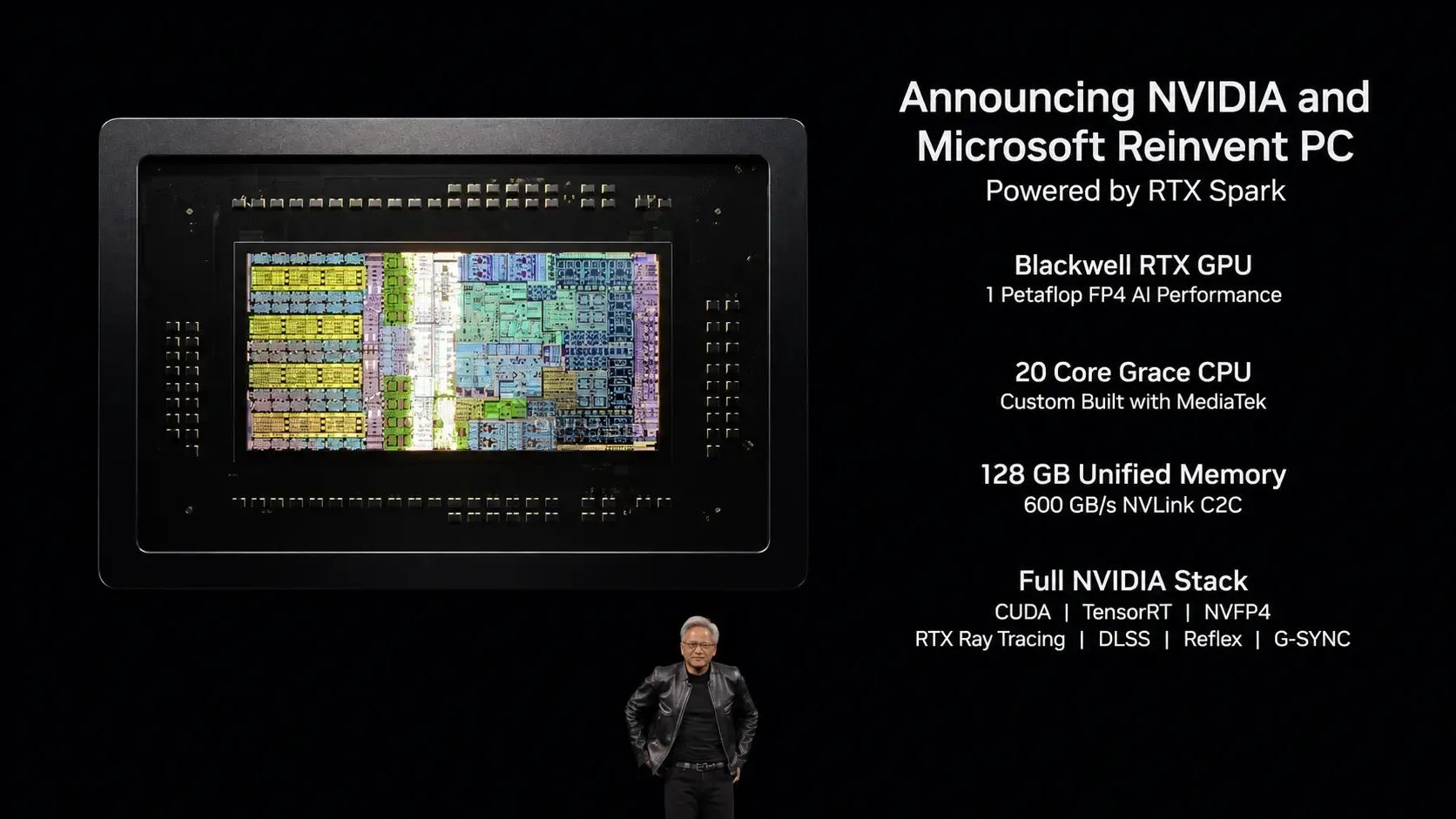













.thumb.jpg.9a921205b9aa72bdfad8ea52635b9d2c.jpg)

